有了這項(xiàng)技術(shù):爆顯存成過去式
來源:驅(qū)動(dòng)之家
?
2019-10-08 14:47:17
10月7日,三星電子宣布率先在業(yè)內(nèi)開發(fā)出12層3D-TSV(硅穿孔)技術(shù)。
隨著集成電路規(guī)模的擴(kuò)大,如何在盡可能小的面積內(nèi)塞入更多晶體管成為挑戰(zhàn),其中多芯片堆疊封裝被認(rèn)為是希望之星。三星稱,他們得以將12片DRAM芯片通過60000個(gè)TSV孔連接,每一層的厚度僅有頭發(fā)絲的1/20。
總的封裝厚度為720μm,與當(dāng)前8層堆疊的HBM2存儲(chǔ)芯片相同,體現(xiàn)了極大的技術(shù)進(jìn)步。
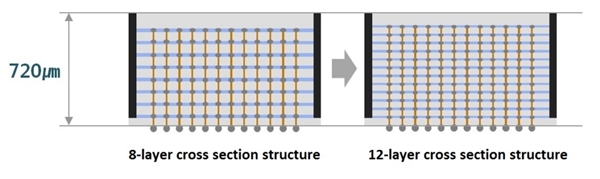
這意味著,客戶不需要改動(dòng)內(nèi)部設(shè)計(jì)就可以獲得更大容量的芯片。同時(shí),3D堆疊也有助于縮短數(shù)據(jù)傳輸?shù)臅r(shí)間。
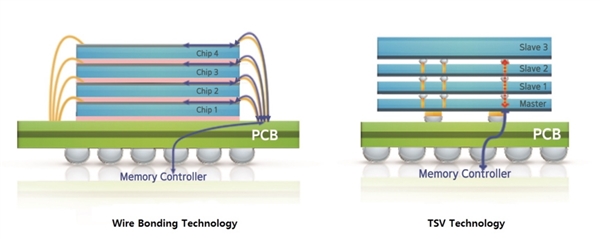
三星透露,基于12層3D TSV技術(shù)的HBM存儲(chǔ)芯片將很快量產(chǎn),單片容量從目前的8GB來到24GB。